| ToF-SIMS PHI7200 Time-of-flight Secondary Ion Mass Spectrometer | Powder X-ray diffractometer-PANalytical |
| For residue Nickel amount confirmation | For characterization of crystallization quality |
 |
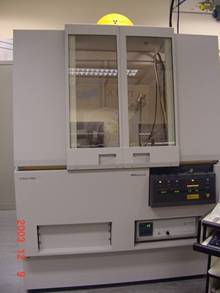 |
| MicroRaman / Photoluminescence System | Resistivity / Hall Measurement System |
| For characterization of crystallization quality | For Hall mobility measurement |
 |
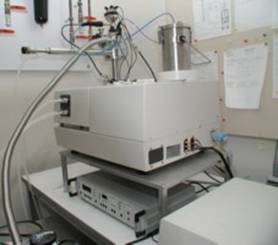 |